永久粘接解决方案
XBS200 晶圆键合机
最大的灵活性和一致的工艺结果:适用于最大 200 mm 晶圆尺寸的通用型 XBS200 晶圆键合机专为 MEMS、LED 和 3D 先进封装的大批量生产而设计。
永久粘接解决方案
最大的灵活性和一致的工艺结果:适用于最大 200 mm 晶圆尺寸的通用型 XBS200 晶圆键合机专为 MEMS、LED 和 3D 先进封装的大批量生产而设计。

专为实现可靠结果而设计
先进的技术,无与伦比的多功能性:XBS200 是高质量、大批量生产的理想晶圆键合机。
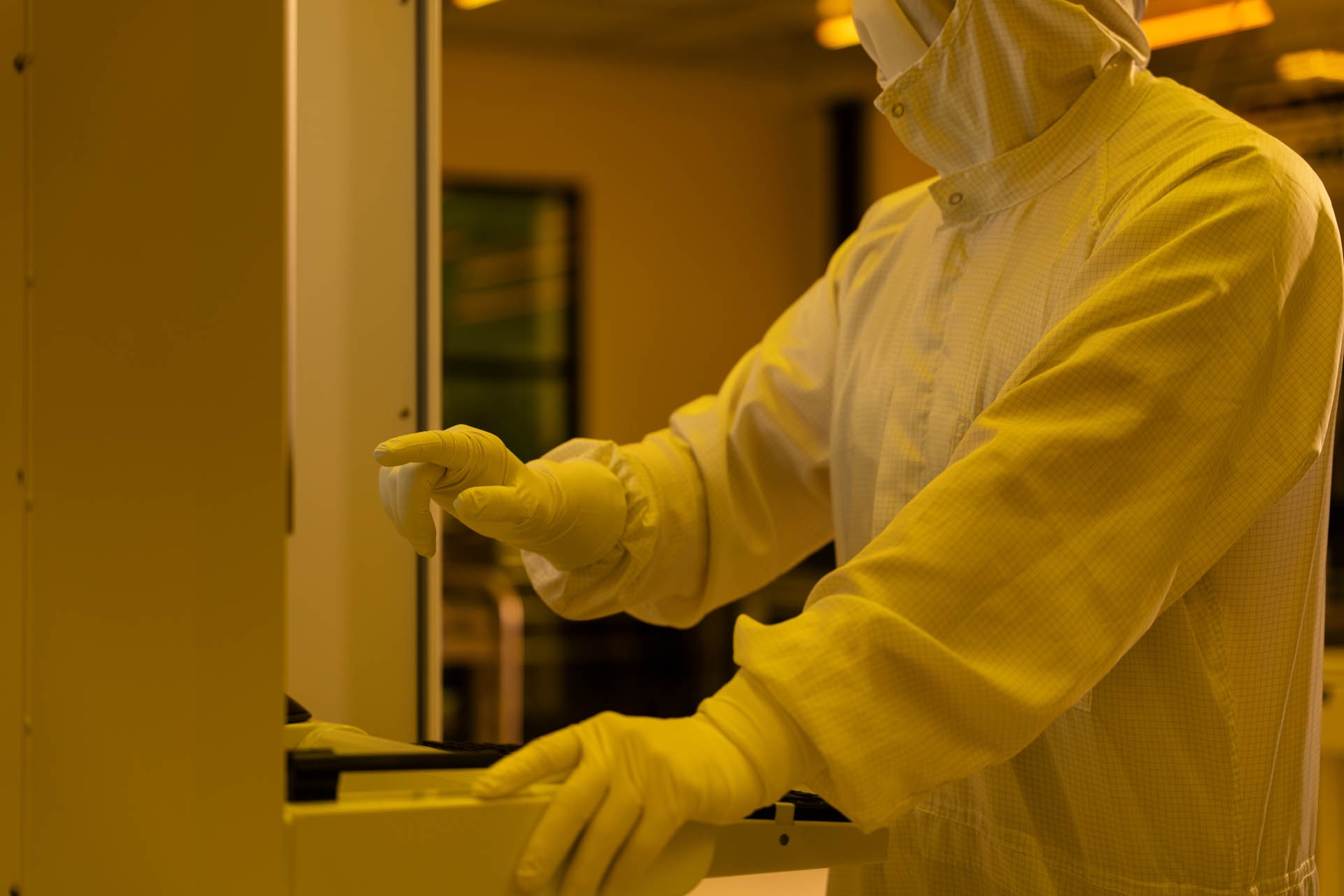
想了解更多详情?请点击下面的链接下载技术数据表和产品介绍,了解更多产品信息。