解键合机工艺解决方案
DB12T 型解键合机
DB12T 解键合机是室温下机械剥离解键合工艺的先进解决方案。该系统可将支撑载片从薄至 50 微米甚至更薄的胶带安装晶圆上分离出来。可用的设备选项支持从 4 英寸到 12 英寸的晶圆尺寸,以及玻璃或硅等各种支撑载片材料。
解键合机工艺解决方案
DB12T 解键合机是室温下机械剥离解键合工艺的先进解决方案。该系统可将支撑载片从薄至 50 微米甚至更薄的胶带安装晶圆上分离出来。可用的设备选项支持从 4 英寸到 12 英寸的晶圆尺寸,以及玻璃或硅等各种支撑载片材料。

可编程精度
DB12T 可让您完全控制所有相关的解键合机参数,从而最大限度地减少解键前沿,最大限度地提高工艺可靠性。
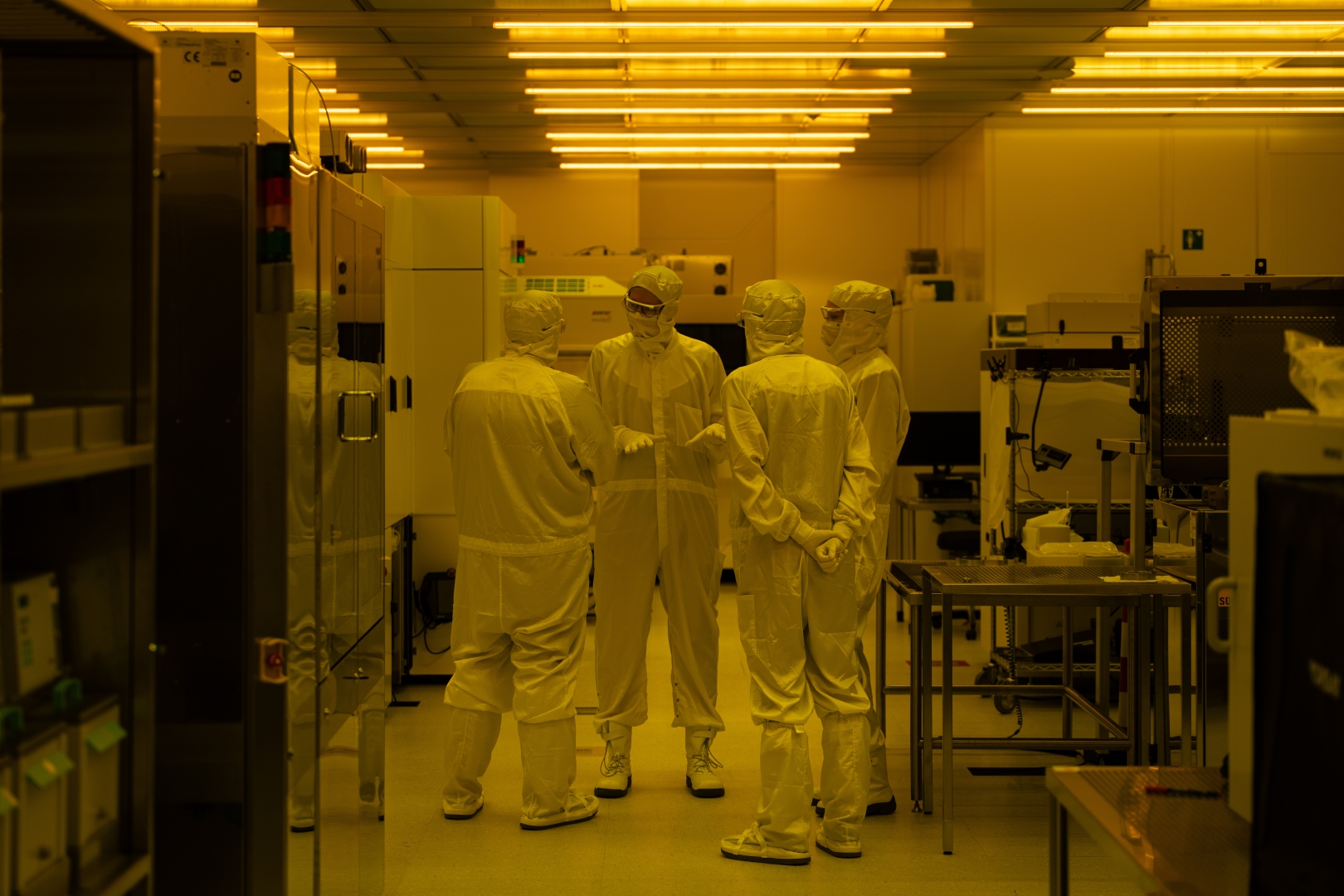
想了解更多详情?请点击下面的链接下载技术数据表和产品介绍,了解更多产品信息。