全自動掩模對準機
MA200 Gen3 掩模對準機
MA200 Gen3 專為 200mm 以下晶圓和方形基板的大批量自動化生產而設計。結合創新的對準技術 與智慧型自動化,是微機電系統 (MEMS)、無線射頻 (RF) 與功率器件的首選系統、
全自動掩模對準機
MA200 Gen3 專為 200mm 以下晶圓和方形基板的大批量自動化生產而設計。結合創新的對準技術 與智慧型自動化,是微機電系統 (MEMS)、無線射頻 (RF) 與功率器件的首選系統、
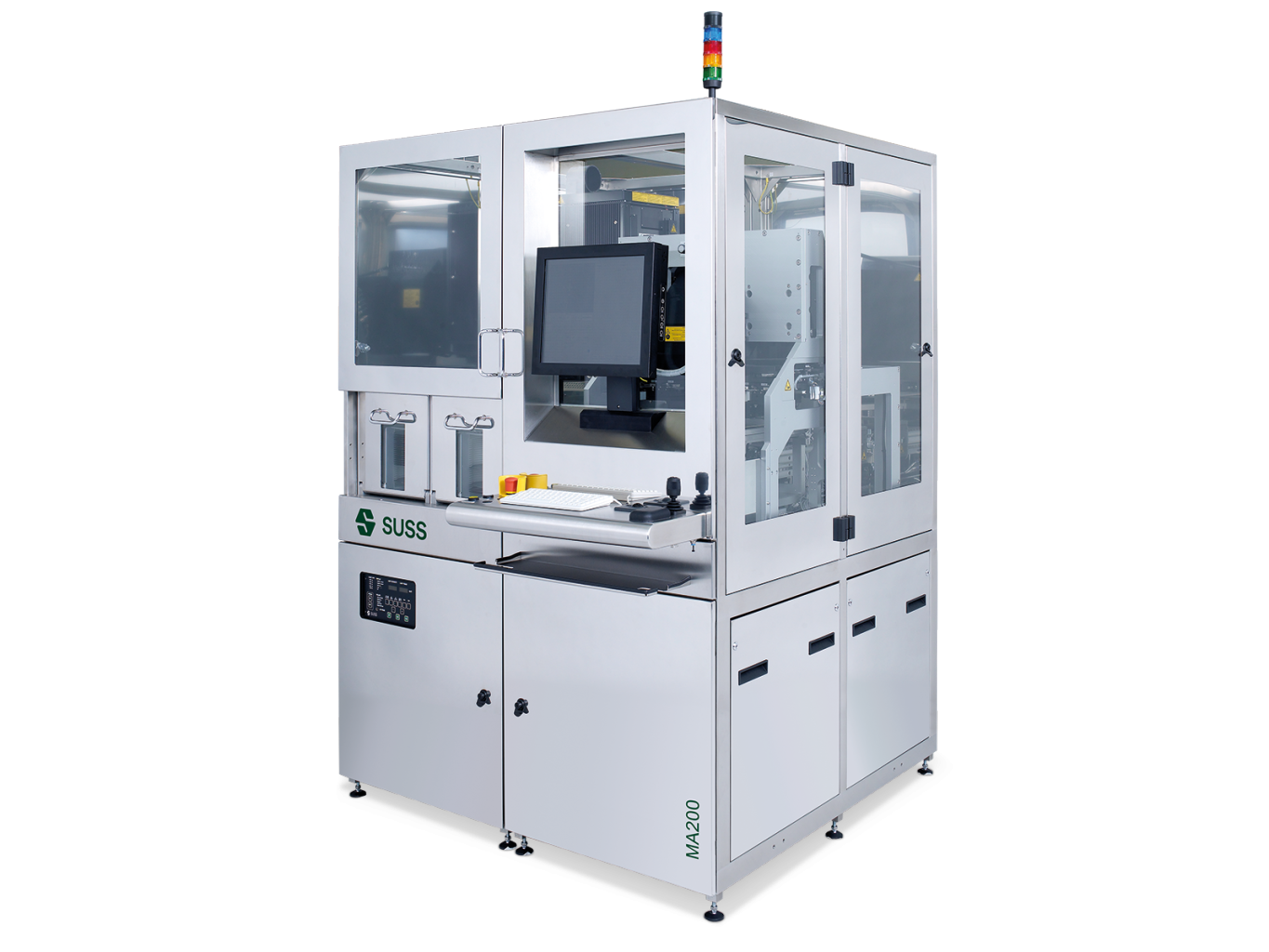
先進封裝的掩模對準機
MA200 Gen3 專為高產量環境所設計,結合了對準精度、先進光學技術和多樣化處理功能,可在各種光刻和封裝製程中提供穩定、可重複的結果。

尋找更多詳細資訊?請點選以下連結,下載技術資料表和深入產品資訊的產品簡報。