鍍膜解決方案
LabSpin 系列 旋轉塗佈與顯影平台
彈性、精準且安全:LabSpin6 與 LabSpin8 為最新一代手動旋轉塗佈/顯影系統,分別支援最大 150 mm 與 200 mm 晶圓。LabSpin 系列專為實驗室與研發 R&D 環境打造,以精巧占地提供對各類光微影化學品的均勻塗佈與高重複性製程表現
鍍膜解決方案
彈性、精準且安全:LabSpin6 與 LabSpin8 為最新一代手動旋轉塗佈/顯影系統,分別支援最大 150 mm 與 200 mm 晶圓。LabSpin 系列專為實驗室與研發 R&D 環境打造,以精巧占地提供對各類光微影化學品的均勻塗佈與高重複性製程表現

掌控每一道製程,加速研發進程
LabSpin 系列以每一步驟皆可控為設計核心。透過可程式化配方 recipes 、可調式轉速與精準加速度設定,您可細緻調校製程並可靠重現,獲得一致且具價值的研發 R&D 成果
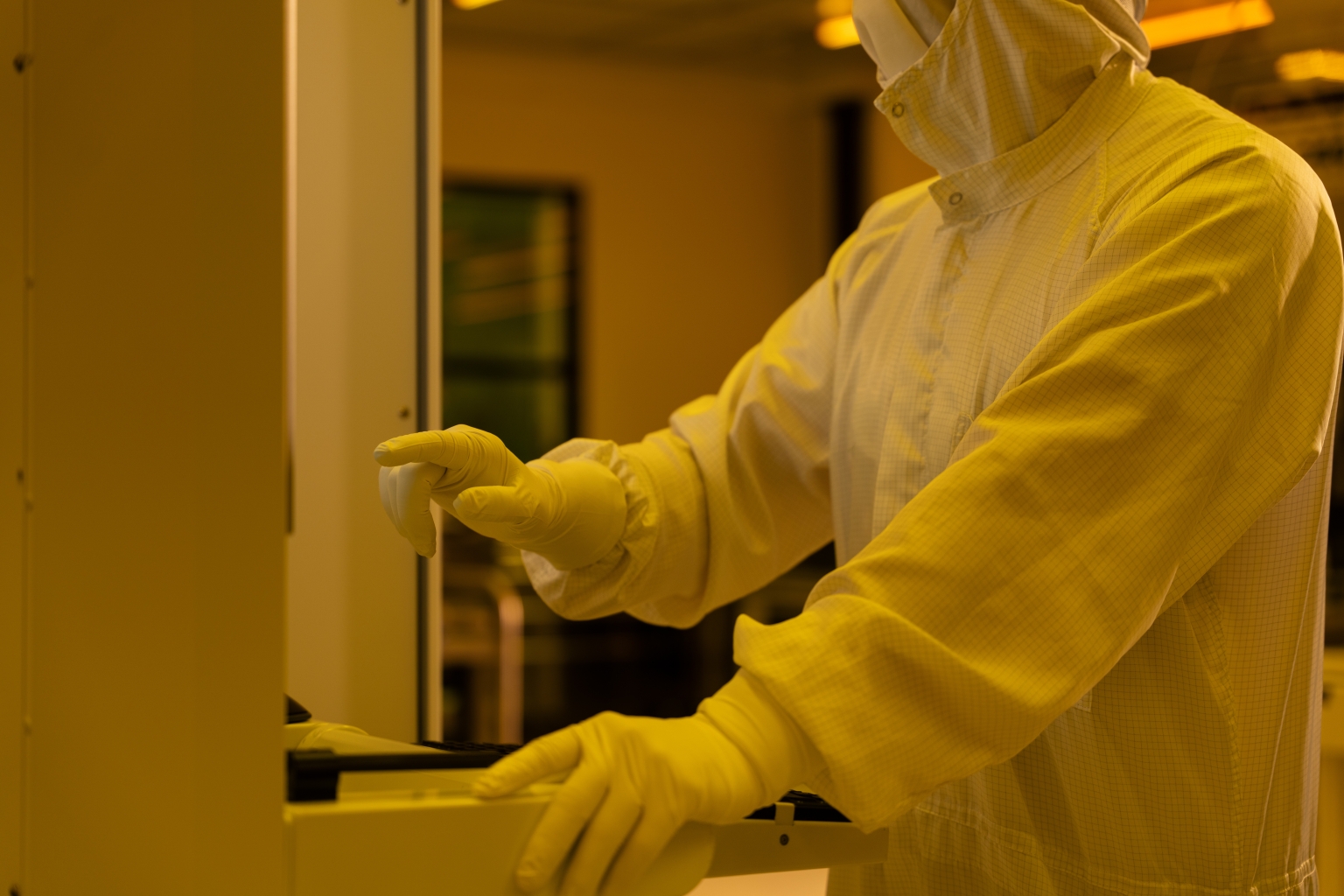
想要瞭解更多詳細資訊?請點選以下連結,下載技術資料表和深入產品資訊的產品簡報。