永久性接合解決方案
XBS200 晶圓鍵合機
最大的靈活性和一致的製程結果:通用型 XBS200 晶圓鍵合機適用於最大 200 mm 的晶圓尺寸,專為 MEMS、LED 和 3D 先進封裝的大批量生產而設計。
永久性接合解決方案
最大的靈活性和一致的製程結果:通用型 XBS200 晶圓鍵合機適用於最大 200 mm 的晶圓尺寸,專為 MEMS、LED 和 3D 先進封裝的大批量生產而設計。

專為可靠的結果而設計
精密的技術,無與倫比的多功能性:XBS200 是高品質、大批量生產的理想晶圓鍵合機。
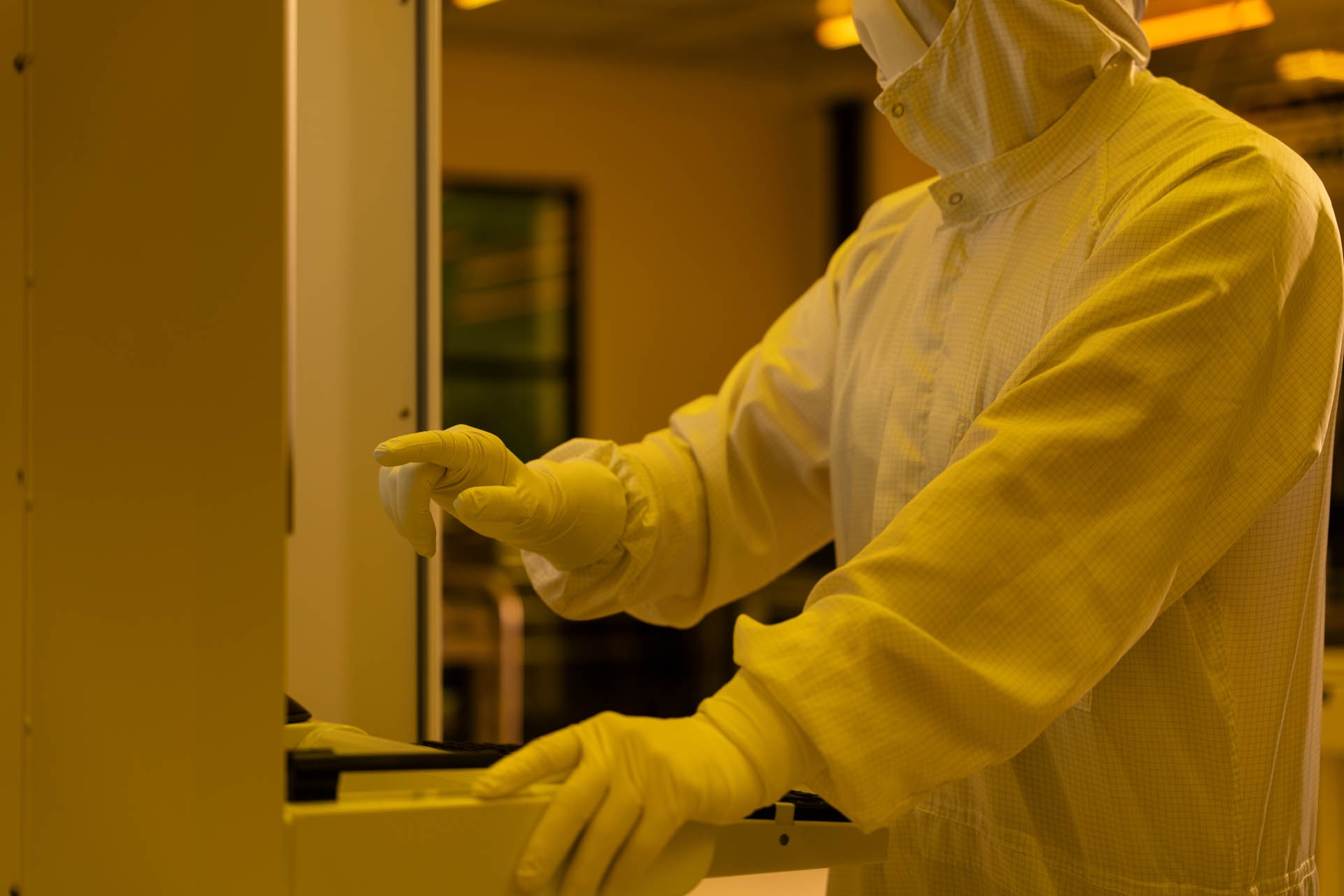
想要瞭解更多詳細資訊?請點選以下連結,下載技術資料表和深入產品資訊的產品簡報。