解鍵合機解決方案
DB12T 解鍵合機
DB12T 解鍵合機是最先進的常溫機械剝離解鍵合工藝解決方案。該系統可從薄至 50 µm 甚至更薄的帶式晶圓上分離出支援載片。可用的設備選項支援的晶圓尺寸從 4「 到 12」,以及各種不同的支架載片材料,例如玻璃或矽片。
解鍵合機解決方案
DB12T 解鍵合機是最先進的常溫機械剝離解鍵合工藝解決方案。該系統可從薄至 50 µm 甚至更薄的帶式晶圓上分離出支援載片。可用的設備選項支援的晶圓尺寸從 4「 到 12」,以及各種不同的支架載片材料,例如玻璃或矽片。

可編程精度
DB12T 可讓您完全控制所有相關的解鍵合機參數 - 因此可將解鍵前端最小化,並將製程可靠性最大化。
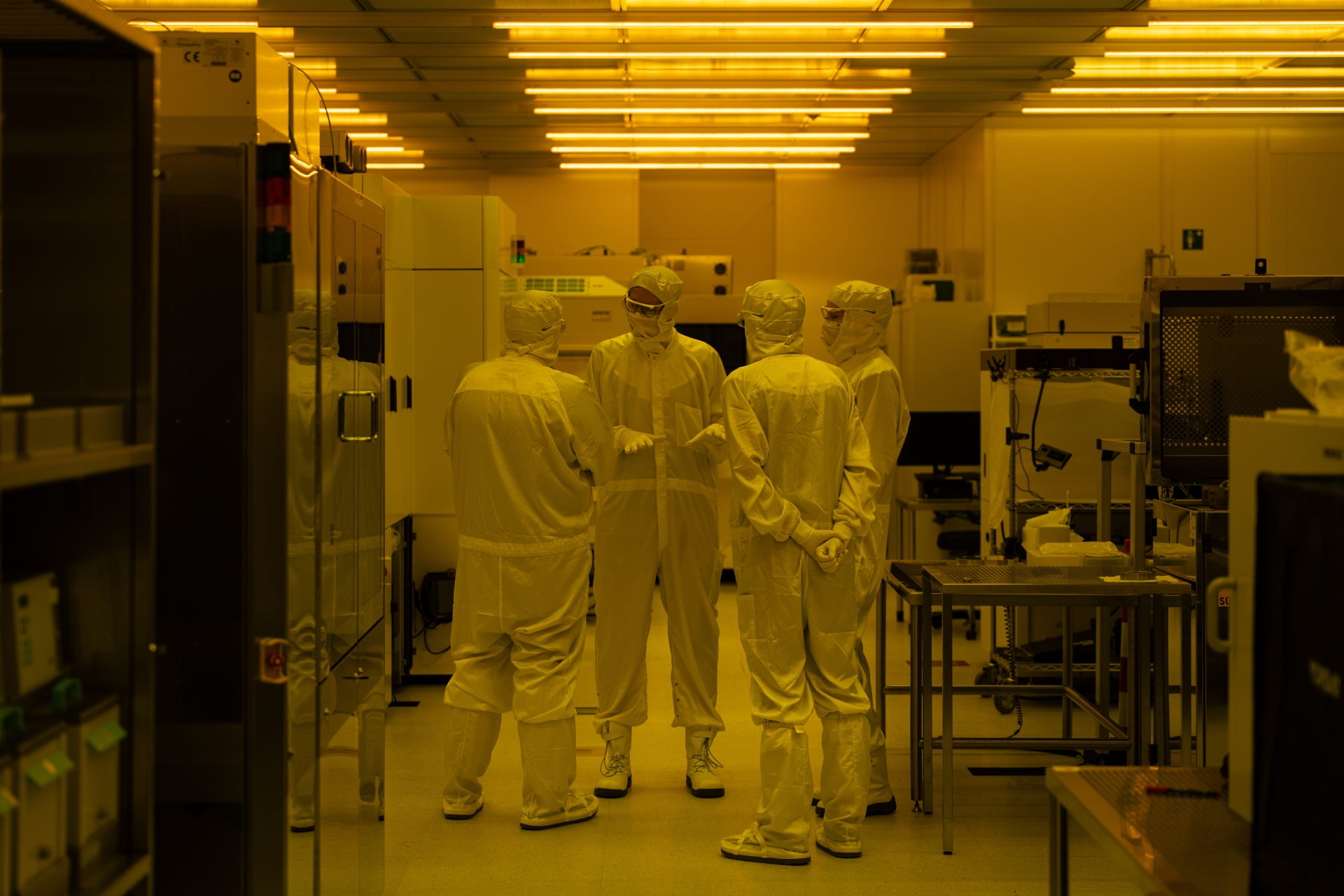
想要瞭解更多詳細資訊?請點選以下連結,下載技術資料表和深入產品資訊的產品簡報。