永久ボンディングソリューション
XBS200 ウェハボンダー
最大200mmまでのウェーハサイズに対応するXBS200ウェーハボンダーは、MEMS、LED、3D先進パッケージングの大量生産向けに設計されています。
永久ボンディングソリューション
最大200mmまでのウェーハサイズに対応するXBS200ウェーハボンダーは、MEMS、LED、3D先進パッケージングの大量生産向けに設計されています。

信頼性の高い結果を得るための設計
洗練されたテクノロジー、比類のない汎用性:XBS200は高品質で大量生産に最適なウェハボンダです。
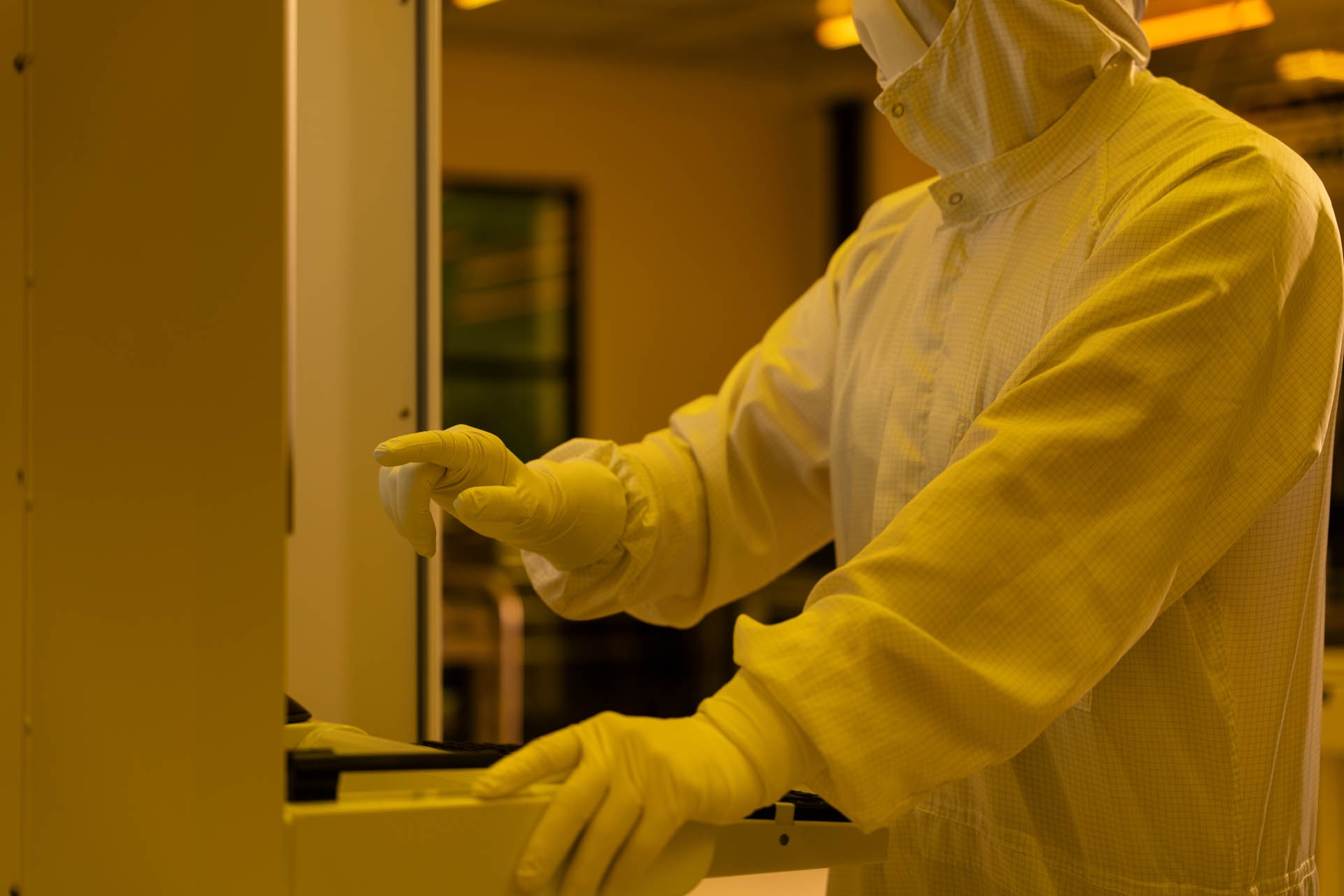
詳細をお探しですか?テクニカル・データシートと、詳細な製品情報が記載された製品プレゼンテーションをダウンロードするには、以下をクリックしてください。